SEMの試料室内で、イオンビームによる試料切削と、切削面の反射電子像観察を繰り返すことで三次元電顕像を取得する
<特徴>
- 高分解能の3D電子顕微鏡解析が可能である(Z軸方向の分解能は10nm~)
- ダイヤモンドナイフでは薄切できない金属やセラミックスなどの材料に対して
断面加工およびSerial sectionの取得も可能である
- 観察領域には制限がある(X軸方向は100μm以下)
| 三次元再構築(マウスコルチ器 700枚程の断層像データを3D再構築後、目的領域を抽出) |
断面加工(セラミックスおよび金属の結晶像の観察・Inlens検出器使用)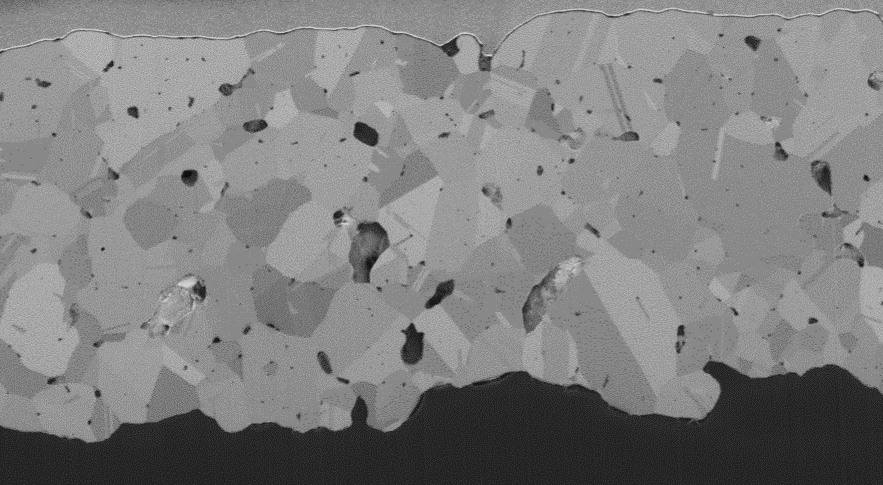 |